



臭氧发生器:ALD工艺中前驱体供给的“精度核心”
在半导体制造向原子尺度不断迈进的今天,原子层沉积(ALD)技术以其卓越的薄膜厚度控制能力和保形性,成为先进制程中不可替代的核心工艺。而在ALD系统中,前驱体的供给稳定性、纯度与反应活性,直接决定了薄膜质量与工艺良率。臭氧发生器,正是这一关键环节中承担前驱体供给任务的核心单元,而臭氧浓度,则是衡量其性能的关键指标之一。
一、臭氧在ALD工艺中的独特价值
在ALD工艺中,常用的氧化前驱体主要包括水(H₂O)、氧气(O₂)和臭氧(O₃)。相较于水和氧气,臭氧具有更高的氧化活性,能够在较低温度下实现更彻底的表面反应,尤其适用于对热预算敏感的新型材料沉积,如高k介质、金属氧化物等。
臭氧作为前驱体,其优势体现在以下几个方面:
1. 高反应活性:臭氧的氧化电位远高于氧气,能够更有效地与金属前驱体反应,形成致密、低杂质的薄膜。
2. 低温工艺适应性:在低温ALD工艺中,臭氧可以弥补水或氧气反应活性不足的问题,拓宽工艺窗口。
3. 良好的界面控制:臭氧氧化层更加均匀,有助于减少界面缺陷,提升器件可靠性。
然而,上述优势的充分发挥,高度依赖于一个核心参数——臭氧浓度。

二、臭氧浓度:决定工艺质量的“第一变量”
在ALD工艺中,臭氧浓度并非一个静态指标,而是直接影响薄膜生长速率、薄膜致密性、杂质含量以及工艺重复性的关键变量。
1. 对薄膜质量的影响
高浓度臭氧能够提供更充足的活性氧物种,促进前驱体分子的完全氧化,减少薄膜中的碳、氢等杂质残留,形成更加致密、缺陷更少的薄膜。对于高k介质如Al₂O₃、HfO₂等,高浓度臭氧工艺往往能够获得更优的介电性能和击穿特性。
2. 对工艺温度的影响
高浓度臭氧可以在更低温度下实现有效的氧化反应,这对于热预算受限的先进逻辑器件和3D堆叠结构尤为重要。例如,在低温ALD制备金属氧化物薄膜时,臭氧浓度往往需要达到120~300 g/Nm³(推荐北京同林科技有限公司AtlasP30、3S-T10高浓度臭氧发生器)甚至更高,以确保反应完全。
3. 对工艺窗口与良率的影响
臭氧浓度的稳定性决定了ALD工艺的重复性。浓度波动会导致每循环生长速率(GPC)发生变化,进而影响膜厚均匀性,影响器件良率。因此,先进制程对臭氧发生器的要求已从“能够产生臭氧”提升至“能够稳定输出高浓度、高纯度的臭氧”。
三、臭氧发生器:高浓度供给的技术挑战
作为前驱体供给单元,臭氧发生器需要在高浓度、高稳定性、高纯度三个维度上同时满足ALD工艺的严苛要求。
1. 高浓度输出
当前先进ALD工艺对臭氧浓度的要求普遍在120~300 g/Nm³范围(推荐北京同林科技有限公司AtlasP30、3S-T10高浓度臭氧发生器),部分高端应用甚至需求更高。实现高浓度臭氧输出,对发生器的放电结构、冷却系统、电源控制以及材料耐氧化性提出了极高要求。传统的空气源或低浓度臭氧发生器已无法满足半导体级应用的需求。
2. 浓度稳定性
ALD工艺以毫秒级脉冲方式交替通入前驱体,臭氧发生器需在快速启停过程中维持浓度的一致性。任何浓度的瞬时波动,都可能被放大为膜厚的显著偏差。因此,发生器需配备高精度浓度监测与反馈控制系统,实现动态调节。
3. 高纯度保障
高浓度臭氧伴随着更强的氧化性,对管路、阀门、密封材料的要求极为苛刻。同时,若发生器中因放电条件不当产生氮氧化物(NOx)等副产物,会引入界面污染,严重影响器件性能。因此,臭氧发生器必须采用高纯氧气源,并优化放电参数,确保输出臭氧的纯度。
四、从沉积到清洗:臭氧的双重角色
除了作为沉积前驱体,臭氧在ALD工艺的前后清洗环节同样发挥着关键作用。在沉积前,高浓度臭氧可用于去除晶圆表面的有机污染物,形成洁净的初始界面;在沉积后,臭氧氧化清洗可有效去除副产物残留,减少颗粒缺陷。
将臭氧发生器同时用于沉积与清洗,不仅简化了设备气路结构,也提升了工艺集成度,降低了运营成本。而在这两种应用场景中,对臭氧浓度的要求都呈现出持续提升的趋势。
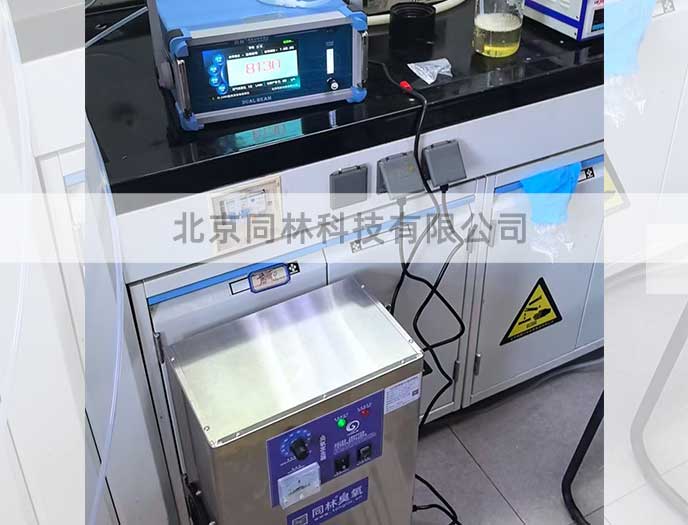
五、技术发展趋势:向更高浓度、更智能控制演进
随着3D NAND、DRAM、先进逻辑器件及新型存储器件对ALD工艺要求的不断提高,臭氧发生器技术也在快速演进:
·高浓度化:通过改进放电介质、优化电源频率与波形、提升冷却效率,实现300 g/Nm³以上稳定输出,满足下一代工艺需求。
·浓度与流量解耦控制:在高流量条件下维持高浓度输出,是实现高产率ALD的关键技术难点。
·智能闭环控制:集成在线浓度传感器与自适应算法,实现臭氧浓度的实时监测与自动补偿,确保批次间工艺一致性。
·小型化与模块化:适应簇式ALD设备对空间布局的严苛要求,便于多腔室独立控制与维护。
结语
在ALD工艺从研发走向大规模量产的过程中,每一个微观层面的精准控制,都依赖于宏观设备系统的可靠支撑。臭氧发生器作为ALD与清洗环节的关键前驱体供给单元,其浓度能力已成为衡量设备工艺能力的重要标尺。
未来,随着半导体工艺不断逼近物理极限,对前驱体供给系统的要求将愈发严苛。臭氧发生器也将从单纯的“供气设备”,演变为具备高浓度输出、高稳定性、智能控制能力的核心工艺模块,在原子尺度的制造舞台上,扮演更加关键的角色。
联系我们
第一时间了解我们的新产品发布和最新的资讯文章。 北京同林科技有限公司是一家是提供高纯高浓度臭氧发生器系统服务商,目前产品包括半导体用高浓度臭氧发生器、臭氧气体分析仪、溶解臭氧分析仪、臭氧水机、半导体用管道和接头等。 已经应用于众多半导体企...
北京同林科技有限公司是一家是提供高纯高浓度臭氧发生器系统服务商,目前产品包括半导体用高浓度臭氧发生器、臭氧气体分析仪、溶解臭氧分析仪、臭氧水机、半导体用管道和接头等。 已经应用于众多半导体企... 您有什么问题或要求吗?
点击下面,我们很乐意提供帮助。 联系我们