



ALD用液化超纯臭氧发生器
超纯臭氧发生器是液化和储存臭氧气体并连续供应高纯度臭氧气体的装置。由于高纯度的臭氧水平,它可以用作半导体工艺中的氧自由基产生源。为了安全起见,本机具有足够的安全措施。
•紧急情况下的防爆设计
•在停电或异常情况下,它可以通过故障安全系统控制温度和压力。
•符合国际安全标准SEMI-S2,UL,NFPA,CE等
•对于防止气体泄漏的安全级别,已通过第三方认证机构的示踪气体测试证明。

原理
臭氧气体在臭氧发生器中产生,在低温冷冻机中冷却,并通过在臭氧室中分离和积累,得到高纯度液态臭氧。
该系统通过蒸发液态臭氧,可以持续供给100%浓度臭氧。
*OER:臭氧-乙烯自由基生成技术
特点
通过我们精心的研发活动,我们成功生成了 OH 自由基,并通过将高浓度臭氧和乙烯在各自分压精确控制的条件下混合,将其高效输送到任何待处理的基板上。
OER* 工艺技术
通过在高纯度和低压条件下运行,始终保持系统安全。
安全措施
安全设计
• 防爆设计
• 通过电源供应实现具有故障安全系统的温度/压力控制。
可靠性
• 具有紧急吹扫机制,可在停电时稀释工艺气体管线中的臭氧并排出设备内的残留臭氧。
• 在发生任何异常时,可通过 EMO(紧急关机)开关手动关闭(冷却器具有防止臭氧爆炸的操作维护功能)。
• 即使在极不可能发生的爆炸情况下,其结构设计通过将液化室置于真空绝缘的不锈钢容器内,可防止对外部设备造成任何机械损坏。
• 液态臭氧冷却单元具有相对于累积液态臭氧量足够的热容量,以降低因振动导致快速汽化的风险,否则这是爆炸的风险因素。
标准认证
• 本设备符合国际标准:SEMI-S2, UL, NFPA, CE 等。
质量保证
• 通过第三方认证机构的气体检漏测试验证了防气体泄漏的安全性。
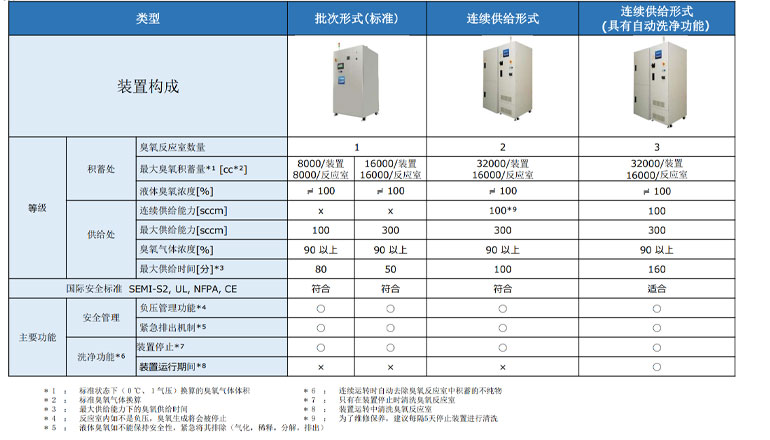
* 1 : 标准状态下(0℃、1气压)换算的臭氧气体体积
* 2 : 标准臭氧气体换算
* 3 : 最大供给能力下的臭氧供给时间
* 4 : 反应室内如不是负压,臭氧生成将会被停止
* 5 : 液体臭氧如不能保持安全性,紧急将其排除(气化,稀释,分解,排出)
* 6 : 连续运转时自动去除臭氧反应室中积蓄的不纯物
* 7 : 只有在装置停止时清洗臭氧反应室
* 8 : 装置运转中清洗臭氧反应室
* 9 : 为了维修保养,建议每隔5天停止装置进行清洗
高质量金属氧化物薄膜的生长
MBE(分子束外延)氧源的示例
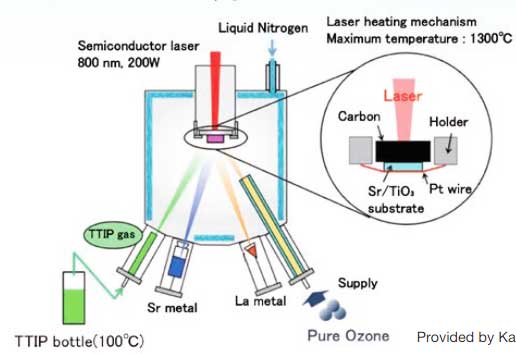
结果
通过使用纯臭氧(高纯铜)气体作为氧源,可以形成高质量的金属氧化物薄膜。
使用纯臭氧(高纯度臭氧)作为氧源的优越性已开始在国际市场上得到认可。
原位清洗
EUV 光刻后原位清洗工艺的示例

结果
低压 & 高反应性源材料原位和全天候(24/7)清洗成为可能。
实现了低浓度(70 升)空气(注:此句原文似乎不完整或有误,按字面翻译)。
仅去除 C 污染而不生长氧化层并保持光束的反射率。
由于使用高纯度臭氧,不含 NOx & HCO(注:此处原文"here OR"含义不明,按字面翻译),因此无材料轻微损伤。
通过此努力,真空完全承载,压力表面确保分子量以处理 100% 浓度臭氧的污染(注:此句原文晦涩,按字面翻译)。
表面改性
碳纤维表面亲水化的示例
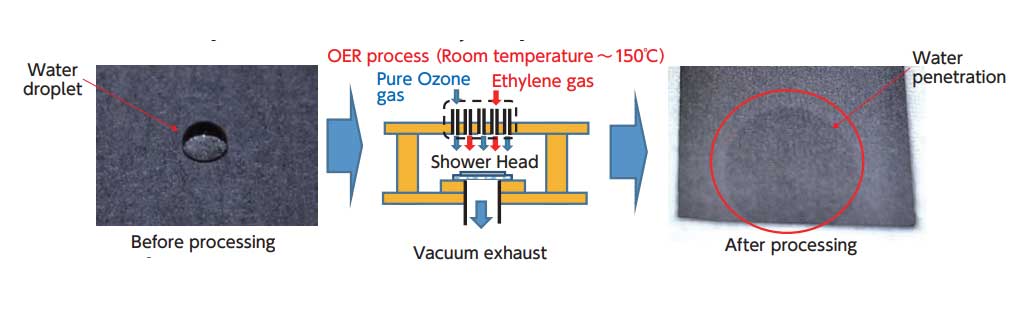
结果
纤维整个表面形成羟基终端
终端持续时间超过 1 个月
确认无热和物理损伤
低温薄膜沉积
高阻隔膜的示例
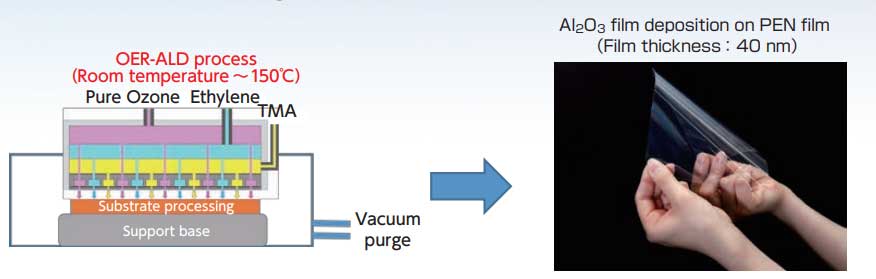
结果
通过在低温下产生的 CH 自由基实现无热和物理损伤。
由于无需额外的预照射时间,实现了高吞吐量工艺。
凭借专有的淋浴头结构和气体流动顺序,在基板上实现高均匀性。
半导体基板上的薄膜沉积
浅沟槽上 SiO₂ 薄膜沉积的示例
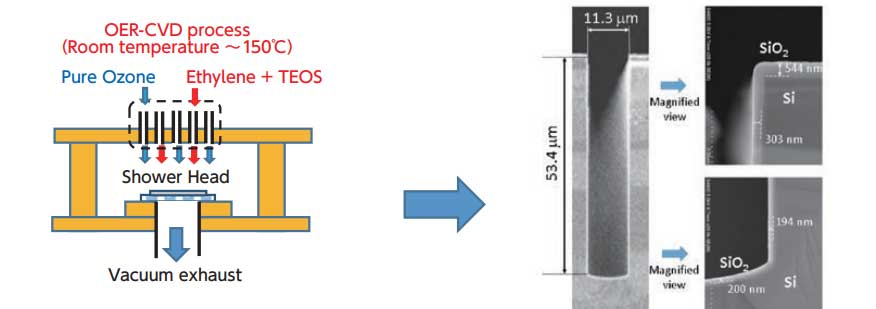
结果
SiO₂ 薄膜可以均匀地沉积在侧壁和沟槽底部(194.2G/cm³)(注:单位G/cm³在此语境下可能为笔误,通常为密度单位,但此处可能指膜厚或密度)。
清洗/去除/灰化
半导体生产工艺中抗蚀剂灰化的示例(高离子注入)
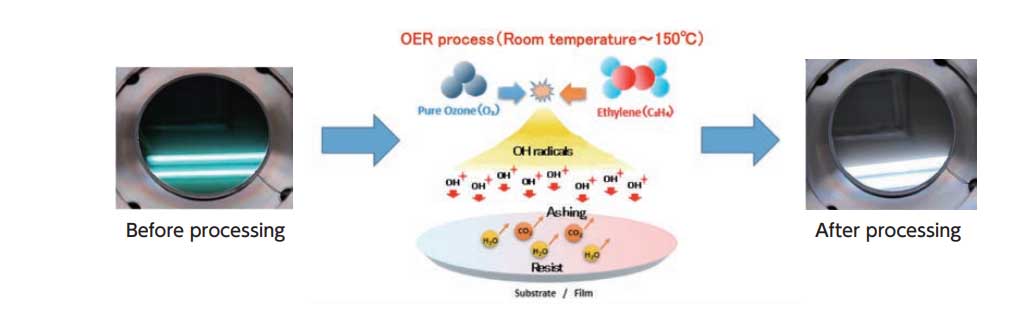
结果
低温下的高速灰化
可以去除高离子注入的光刻胶而无需 popping(爆裂)。
联系我们
第一时间了解我们的新产品发布和最新的资讯文章。 北京同林科技有限公司是一家是提供高纯高浓度臭氧发生器系统服务商,目前产品包括半导体用高浓度臭氧发生器、臭氧气体分析仪、溶解臭氧分析仪、臭氧水机、半导体用管道和接头等。 已经应用于众多半导体企...
北京同林科技有限公司是一家是提供高纯高浓度臭氧发生器系统服务商,目前产品包括半导体用高浓度臭氧发生器、臭氧气体分析仪、溶解臭氧分析仪、臭氧水机、半导体用管道和接头等。 已经应用于众多半导体企... 您有什么问题或要求吗?
点击下面,我们很乐意提供帮助。 联系我们