



| 特点分类 | 具体描述 |
|---|---|
| 厚度控制 | 每个 ALD 循环生长 0.1-1 纳米薄膜,通过控制循环次数实现纳米级至亚纳米级精度。 |
| 均匀性与一致性 | 在平面和高深宽比结构上均能实现高度均匀的薄膜沉积。 |
| 低温兼容性 | 臭氧高反应活性使其可在较低温度下反应,适用于热敏感材料和器件结构。 |
| 材料适用性 | 可沉积多种金属氧化物薄膜,如 Al₂O₃、HfO₂、TiO₂、ZrO₂等,用于先进半导体器件。 |
| 缺陷密度 | 自限制反应机制使薄膜缺陷密度低,界面特性良好。 |
前驱体通入→吸附→惰性气体吹扫→臭氧通入→氧化反应→惰性气体吹扫→循环开始
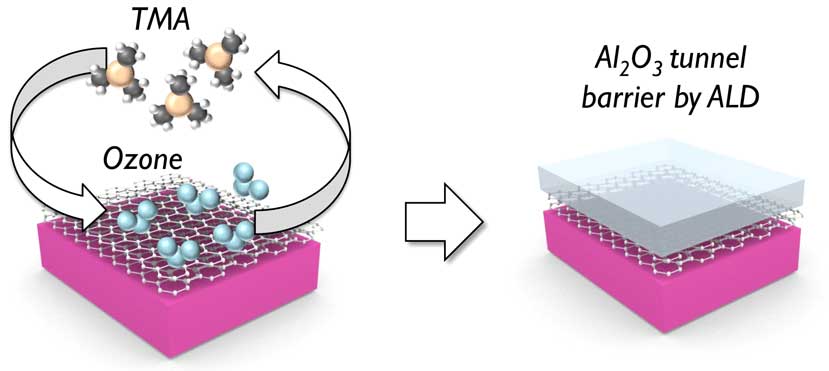
展示单原子层逐次沉积的过程,体现厚度可控性。

联系我们
第一时间了解我们的新产品发布和最新的资讯文章。 北京同林科技有限公司是一家是提供高纯高浓度臭氧发生器系统服务商,目前产品包括半导体用高浓度臭氧发生器、臭氧气体分析仪、溶解臭氧分析仪、臭氧水机、半导体用管道和接头等。 已经应用于众多半导体企...
北京同林科技有限公司是一家是提供高纯高浓度臭氧发生器系统服务商,目前产品包括半导体用高浓度臭氧发生器、臭氧气体分析仪、溶解臭氧分析仪、臭氧水机、半导体用管道和接头等。 已经应用于众多半导体企... 您有什么问题或要求吗?
点击下面,我们很乐意提供帮助。 联系我们