



臭氧在湿法化学清洗中的应用场景
在半导体制造的湿法化学清洗工艺中,臭氧(O₃)凭借其强氧化性、易分解无残留的特性,成为去除有机污染物、金属离子及颗粒杂质的关键材料。以下是湿法化学清洗中臭氧的核心应用场景。
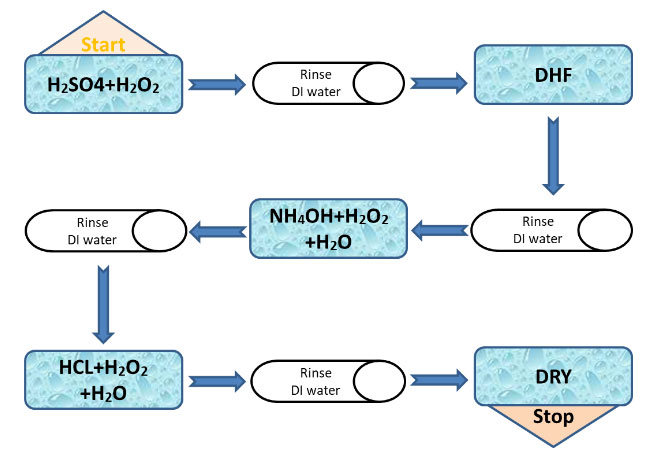
1. 硅片表面有机污染物去除(如光刻胶残留、碳氢化合物)
场景:光刻工艺后、离子注入后、薄膜沉积前的硅片清洗。
原理:臭氧在水溶液中分解产生羟基自由基(・OH),与有机分子发生氧化反应,生成 CO₂和 H₂O 等无害物质。
典型工艺:
臭氧水清洗(O₃+H₂O):将臭氧通入去离子水(DI 水)中形成臭氧水,通过氧化作用分解硅片表面的光刻胶残留或有机物。
臭氧 - 硫酸混合液清洗(SPM 工艺):臭氧与浓硫酸(H₂SO₄)混合,形成强氧化体系(氧化电位>2.0V),用于去除顽固有机污染物(如等离子体刻蚀后的聚合物残留)。
2. 金属离子钝化与去除(如 Na⁺、Fe³⁺、Cu²⁺等)
场景:外延生长前、栅极氧化前的硅片预处理。
原理:臭氧将金属离子氧化为高氧化态化合物(如 Fe³⁺→Fe₂O₃),使其从表面脱附并溶解于清洗液中;同时在硅片表面形成极薄的氧化层(SiO₂),抑制金属离子再吸附。
典型工艺:
臭氧 - 氨水混合液清洗(SC-1 工艺改良):在传统 SC-1 液(NH₄OH+H₂O₂+H₂O)中通入臭氧,增强氧化能力,将金属离子氧化后通过氨水的络合作用去除,同时减少 H₂O₂的用量(降低硅片腐蚀风险)。
3. 颗粒污染物去除与表面改性
场景:晶圆键合前、MEMS 器件清洗。
原理:臭氧氧化使颗粒表面羟基化(-OH),增强颗粒与硅片表面的电荷排斥力,配合超声波或兆声波清洗,促使颗粒脱落;同时氧化后的硅片表面更亲水,提升后续工艺的附着力。
典型工艺:
臭氧水 + 兆声波清洗:在臭氧水溶液中加入兆声波(频率>1MHz)振动,利用空化效应和氧化作用双重机制去除亚微米级颗粒(如 SiO₂、金属氧化物颗粒)。
4. 高纯度材料清洗(如 GaN、SiC 等宽禁带半导体)
场景:第三代半导体衬底清洗、功率器件制造。
需求:宽禁带半导体对表面缺陷更敏感,需避免传统强酸强碱清洗导致的晶格损伤。
工艺特点:采用低浓度臭氧水温和清洗,通过氧化作用去除表面碳污染和金属杂质,同时保持衬底表面的原子级平整度。
臭氧在半导体湿法化学清洗中扮演着 “绿色氧化剂” 的角色,其应用贯穿硅片制造、器件加工到封装的多个环节。通过精准控制臭氧浓度、与其他化学品的协同作用及设备材质兼容性,可实现有机污染物分解、金属离子钝化和颗粒去除的多重目标。
联系我们
第一时间了解我们的新产品发布和最新的资讯文章。 北京同林科技有限公司是一家是提供高纯高浓度臭氧发生器系统服务商,目前产品包括半导体用高浓度臭氧发生器、臭氧气体分析仪、溶解臭氧分析仪、臭氧水机、半导体用管道和接头等。 已经应用于众多半导体企...
北京同林科技有限公司是一家是提供高纯高浓度臭氧发生器系统服务商,目前产品包括半导体用高浓度臭氧发生器、臭氧气体分析仪、溶解臭氧分析仪、臭氧水机、半导体用管道和接头等。 已经应用于众多半导体企... 您有什么问题或要求吗?
点击下面,我们很乐意提供帮助。 联系我们