



臭氧基原子层沉积制备高质量HfO₂与Al₂O₃薄膜的关键工艺
臭氧(O₃)与原子层沉积(ALD,Atomic Layer Deposition)技术的结合,是现代微电子制造、光学镀膜及先进功能薄膜研究中的关键工艺组合。O₃作为一种强氧化剂,其反应活性介于H₂O和O₂等离子体之间,但避免了等离子体可能引起的衬底损伤,且能提供更致密、含碳量更低的薄膜。

1. 臭氧的发生与浓度控制
臭氧是ALD工艺的“前驱体B”,其质量直接决定氧化效果。
1.1发生方式:通常使用高纯O₂通过臭氧发生器(常采用介质阻挡放电)制备。根据浓度需求,可分为:
高浓度(~15-20 wt%):适用于需要极高薄膜密度或低温沉积的场景,推荐北京同林科技有限公司Atlas P30高浓度臭氧发生器。
低浓度(~5-10 wt%):适用于常规沉积,避免过度氧化导致的界面层生长,推荐北京同林科技有限公司3S-T10高浓度臭氧发生器。
1.2关键考量:O₃半衰期短,需保证从发生器到反应腔的管路尽可能短且使用不参与臭氧反应的材质(如不锈钢、特氟龙),以减少浓度损耗。
2. 衬底温度:权衡反应动力学与膜质
温度是臭氧ALD中核心的工艺参数,存在一个“ALD温度窗口”。
2.1对于HfO₂薄膜
低温区(< 200°C):
挑战:O₃分解速率慢,反应不完全。薄膜中易残留羟基或碳杂质,导致薄膜疏松、漏电流增大。
策略:若必须低温(如柔性衬底),需采用高浓度臭氧或长脉冲/长吹扫时间来辅助反应。
中高温区(250°C - 350°C):
关键窗口:这是制备高质量HfO₂的理想区间。
机制:在此温度下,O₃在HfO₂表面高效分解为活性氧自由基,与Hf前驱体(如TDMAH或TEMAH)的配体发生完全氧化反应。薄膜致密,杂质含量极低。
注意:温度过高(> 400°C)可能导致O₃在到达表面前即气相分解,降低利用率,同时可能引起HfO₂的早期晶化(通常希望非晶态以降低漏电),晶界会成为漏电通道。
2.2对于Al₂O₃薄膜
宽温度窗口(100°C - 300°C):
Al₂O₃的ALD工艺相对鲁棒。使用TMA(三甲基铝)与O₃反应非常剧烈。
低温区特性:
即使低至80-100°C,O₃也能与TMA有效反应,生成Al₂O₃。相比于H₂O基工艺,O₃在低温下能更有效地去除甲基,减少羟基残留,薄膜更致密。
高温区特性:
> 300°C时,需注意TMA可能发生热分解(CVD效应),破坏自限制生长。但O₃的强氧化性可以快速氧化分解产物,一定程度上抑制CVD效应,维持ALD模式的线性生长。
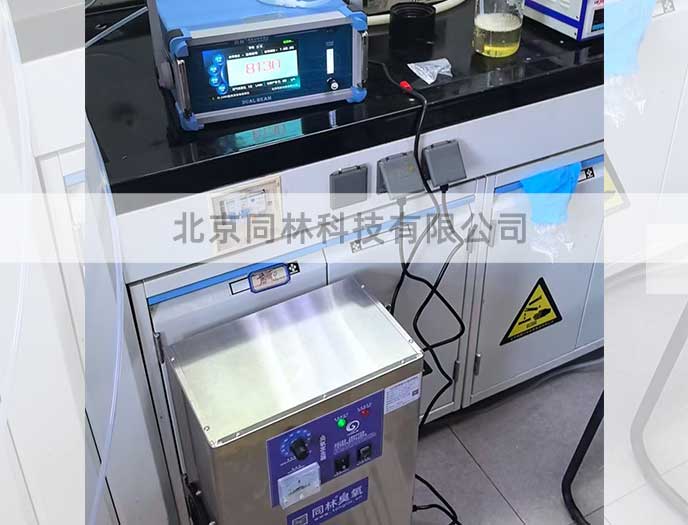
3. 脉冲与吹扫时间:确保饱和与清除
前驱体脉冲:需确保金属前驱体(Hf前驱体或TMA)在衬底表面达到饱和化学吸附。
O₃脉冲:
关键点:O₃脉冲不仅要长到足以氧化全部吸附的金属前驱体,还要能渗透进已经形成的薄膜网络,氧化深层悬挂键。
过短:氧化不彻底,薄膜呈缺氧状态(Suboxide),导致光学吸收增加、电学性能劣化。
过长:可能导致衬底本身(如硅片)被过度氧化,形成较厚的低k界面层(SiO₂),影响等效氧化层厚度(EOT)。
吹扫时间:必须足够长以清除副产物(如H₂O、CO₂、N₂、CH₄等)和未反应的O₃,防止CVD模式发生。
4. 界面工程与初始成核
对于HfO₂/Al₂O₃叠层结构(如在DRAM电容或逻辑器件中),初始界面至关重要:
表面预处理:沉积前通常对硅基底进行O₃预处理,形成一层化学性质稳定、厚度可控的化学氧化层(Chemical Oxide),这层氧化物有利于HfO₂的均匀成核。
界面偶极层:在Al₂O₃插入层上沉积HfO₂时,O₃基工艺能精确控制界面处的混合程度,有助于调控器件的阈值电压(Vt)。
5. 薄膜性质与工艺的关联
| 薄膜性质 | 关键工艺影响(O₃ vs. H₂O) | 应用要求 |
|---|---|---|
| 致密性与折射率 | O₃基薄膜通常折射率更高(更接近块材理论值),表明薄膜更致密。 | 光学涂层需要高折射率;栅介质需要高介电常数。 |
| 杂质含量 | O₃能有效将碳、氯等杂质氧化为挥发性气体排出,薄膜纯度极高。 | 降低漏电流,提高击穿场强。 |
| 台阶覆盖率 | O₃工艺的高反应活性配合长曝光时间,能在极高深宽比结构(如沟槽)中实现完美共形覆盖。 | 3D NAND和DRAM电容制造的核心要求。 |
| 界面层生长 | O₃会轻微氧化基底(如Si),生成SiO₂或硅酸盐界面层。需精确控制O₃剂量和温度以限制界面层厚度。 | 维持等效氧化层厚度(EOT)的缩放。 |
6. 工艺挑战与解决方案
挑战1:基底氧化
现象:O₃穿透已沉积的薄膜氧化底部硅衬底。
解决方案:采用“栅极后(Gate-last)”工艺;或在沉积初期使用较弱的氧化剂(如H₂O)沉积一层薄阻挡层,再切换为O₃。
挑战2:O₃分解产物
现象:O₃分解产生高能氧原子,可能对有机或二维材料衬底造成损伤。
解决方案:降低沉积温度,使用脉冲O₃而非连续流,或稀释O₃浓度。
总结
利用臭氧ALD制备高质量的HfO₂和Al₂O₃薄膜,关键在于 “三要素的平衡” :
1. 温度:选择在前驱体稳定且O₃具有高反应活性的温度窗口。
2. 臭氧剂量:确保完全氧化,同时避免过度的界面损伤。
3. 表面控制:处理好初始成核层和界面反应。
通过精细调控上述参数,臭氧ALD能够沉积出具有原子级厚度控制、优异电学性能(低漏电流、高介电常数)和高致密性的HfO₂与Al₂O₃薄膜,满足从先进逻辑芯片、DRAM存储到高端光学镀膜的严苛需求。
联系我们
第一时间了解我们的新产品发布和最新的资讯文章。 北京同林科技有限公司是一家是提供高纯高浓度臭氧发生器系统服务商,目前产品包括半导体用高浓度臭氧发生器、臭氧气体分析仪、溶解臭氧分析仪、臭氧水机、半导体用管道和接头等。 已经应用于众多半导体企...
北京同林科技有限公司是一家是提供高纯高浓度臭氧发生器系统服务商,目前产品包括半导体用高浓度臭氧发生器、臭氧气体分析仪、溶解臭氧分析仪、臭氧水机、半导体用管道和接头等。 已经应用于众多半导体企... 您有什么问题或要求吗?
点击下面,我们很乐意提供帮助。 联系我们