



PLD(脉冲激光沉积)工艺流程与操作步骤
PLD 工艺的基本流程包括靶材准备、基底处理、设备准备、工艺参数设置、沉积过程和薄膜表征等步骤。以下是 PLD 工艺的详细流程和操作步骤:
靶材准备:
根据所需薄膜材料选择合适的靶材,靶材纯度通常要求在 99.9% 以上
靶材尺寸一般为直径 25.4mm× 厚度 3mm 的圆片,对于非低熔点或易挥发材料适用性较好
清洁靶材表面,去除油污和杂质,确保表面光洁
基底处理:
选择合适的基底材料,根据应用需求可以是硅片、蓝宝石、石英或其他衬底
对基底进行严格清洗,通常包括有机溶剂清洗、去离子水冲洗和干燥等步骤
必要时对基底进行表面处理,如化学刻蚀、等离子体处理或退火处理,以改善表面状态和附着力
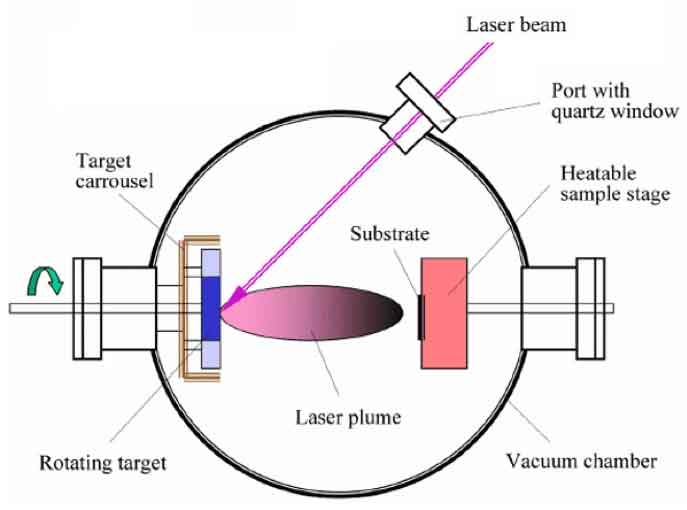
设备准备:
检查 PLD 系统各部件是否正常工作,包括激光器、真空系统、靶材夹具和基底支架等
安装靶材和基底,确保靶材与基底之间的距离 (靶基距) 在 50-80mm 范围内可调
连接真空泵系统,确保系统能够达到所需的真空度
安装并校准各种测量和监控设备,如真空计、测温仪和 RHEED 系统 (如配备)
工艺参数设置:
设置激光器参数,包括波长、能量密度、脉冲频率和脉冲宽度等。典型的 PLD 参数为:波长 193-351nm,脉冲能量可达 750mJ,能量密度约为 1-3J/cm²,脉冲宽度 12-20ns,脉冲频率 1-30Hz
设置真空系统参数,包括本底真空度和工作气压。沉积腔体经烘烤后本底极限真空度通常优于 2×10⁻⁸Torr,工作气压根据需要可调
设置基底温度参数,通常在室温至 900℃范围内可调
设置臭氧流量 (如果使用臭氧 PLD),控制反应气氛
沉积过程:
开启真空泵系统,将沉积腔室抽至所需的本底真空度
加热基底至设定温度,通常需要保持一段时间以确保温度均匀
开启激光器,调节激光能量和聚焦状态,使其准确轰击靶材表面
控制沉积时间,达到所需的薄膜厚度后停止激光轰击
关闭加热系统,保持真空或通入保护性气体,让基底自然冷却
薄膜表征:
从沉积腔室中取出薄膜样品
使用各种表征技术评估薄膜质量,包括厚度测量、结构分析、成分分析和电学性能测试等
根据表征结果,调整工艺参数,优化后续沉积过程
在实际操作中,PLD 系统的操作还包括一些安全注意事项和特殊步骤:
激光操作必须严格遵守安全规程,避免激光直接照射人体
在沉积过程中,应密切监控各种参数的稳定性,如激光能量、真空度和温度等
对于臭氧 PLD,臭氧的使用需要特别注意安全,确保系统密封性良好,防止臭氧泄漏
沉积结束后,应先关闭臭氧发生器,再关闭其他系统组件
联系我们
第一时间了解我们的新产品发布和最新的资讯文章。 北京同林科技有限公司是一家是提供高纯高浓度臭氧发生器系统服务商,目前产品包括半导体用高浓度臭氧发生器、臭氧气体分析仪、溶解臭氧分析仪、臭氧水机、半导体用管道和接头等。 已经应用于众多半导体企...
北京同林科技有限公司是一家是提供高纯高浓度臭氧发生器系统服务商,目前产品包括半导体用高浓度臭氧发生器、臭氧气体分析仪、溶解臭氧分析仪、臭氧水机、半导体用管道和接头等。 已经应用于众多半导体企... 您有什么问题或要求吗?
点击下面,我们很乐意提供帮助。 联系我们